覆晶封装底部充填模块 Underfill
覆晶封装底部充填模块 Underfill
可模拟三维流动情形,以及在波前处因表面张力作用造成的曲率分布与毛细现象,更进一步加入反应动力模式与黏度模式,以仿真覆晶底胶的充填行为。亦可让使用者输入真实的点胶设定,进而预测接点间隔 (Bump Pitch) 与接点分布 (Bump Pattern) 对充填过程的影响,提升产品良率,达成有效控制成本的目的。
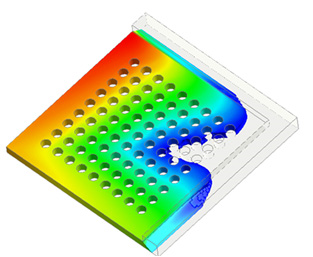
Moldex3D芯片封装底部填胶模块支持毛细流动计算,在芯片与基板间的隙间以表面张力为驱动力的封装行为,而表面张力将受环氧树脂与各别组件接触角的不同而有不同的驱动力。一般来说覆晶都是较低的热膨胀系数,所以容易在热循环过程中影响发生变形;过度的变形将导致芯片机械疲劳、功能缺陷或断裂问题。因此,底部填胶模拟制程被开发用来提高覆晶开发的质量与可靠度。
挑战
■考虑表面张力效应做精确的分析
■预估环氧树脂充填波前的稳定性
Moldex3D 解决方案
■可视化芯片与基板间的毛细管现象所产生的充填行为
■可视化动态点胶制程的充填行为
■分析点胶参数设定及环氧树脂与组件间的接触角
■评估锡球间距离和锡球排列图案对覆晶填充的影响
■预测包封位置并防止充填产生的潜在缺陷
■实现成型优化且降低成本